由于具有强大的电流泄放能力,SCR(silicon controlled rectifier)结构的ESD(electrostatic discharge)器件常被用于智能电源集成电路的高电压电源ESD保护电路[1]。但是,SCR结构的寄生PNP BJT管和NPN BJT管之间的正反馈,在漏极和源极之间形成了一个的准中性区域和相对低的电场,从而极大地减少了维持电压,产生了闩锁风险,降低了器件的鲁棒性[2]。为了提高维持电压,研究人员提出了一些基于SCR结构的改进设计,如插入一个P+区[3],增加一个N型注入层[4],增加衬底与漏极的镇流器电阻[5]等,器件仿真也得到了广泛的应用[6] 。此外,使用更大的阳极-阴极间距能增加器件的维持电压[7],延长P阱中的P+注入区长度增强器件的功率耗散能力[8],加大漏区到栅极间距有更高的二次击穿电流[9]。由此可见,改变SCR ESD器件的区域间距也可用于调节器件的健壮性或者放电能力,满足智能电源集成电路的高压ESD防护需求。为了研究高压SCR ESD器件的结构尺寸与器件性能的关系,本文设计了两组高压SCR ESD器件,采用标准的0.5 mm 5 V/18 V的CDMOS工艺流片,使用传输线脉冲(TLP)测试系统获取器件工作的I-V特性曲线、维持电压和失效电流,并对测试结果进行了器件鲁棒性和放电性能分析。
1 器件结构和测试方法高压SCR ESD器件的横截面示意图如图 1所示。每个器件测试区域的I-V特性曲线、维持电压Vhold和失效电流由Thermo Celestron-I传输线脉冲(TLP)测试系统测量,脉冲的上升/下降时间都是10 ns,脉冲宽度为100 ns,以模拟实际的ESD应力。维持电压是评估器件鲁棒性的重要指标,因为相对其他结构的ESD器件,SCR结构器件的维持电压非常低,正常工作条件下,衬底上的小噪声电流有可能使SCR ESD器件导通,产生破坏性的闩锁现象。很大程度上,SCR ESD器件的泄放性能由器件的二次击穿电流来确定,此时器件失效,二次击穿电流也称为失效电流。测试过程中,随着所加脉冲电压增大,器件的漏电流增大,规定检测到漏电流的值超过初值的30%为软击穿,此时的放电电流为软失效电流。如果检测到漏电流大于1 mA,认为器件硬击穿损坏,此时的放电电流为硬失效电流。失效电流除以器件面积求得单位面积的失效电流(mA/mm2),使用单位面积的软失效电流Isoft和硬失效电流Ihard衡量器件的泄放效率和保护水平。
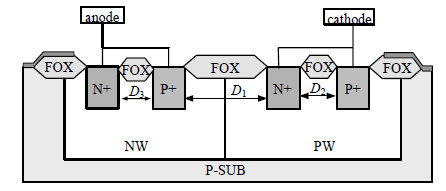 |
| 图1 高压SCR ESD保护器件横截面 |
如图 1所示,D1是N阱内P+注入区和P阱内N+注入区间距,D2是P阱内P+区和N+区间距。采用标准的0.5 mm的5 V/18 V CDMOS工艺制造了二组高压SCR ESD保护器件,第一组中3个器件D1长度不同,面积分别为:1 251 、1 675 、2 099 mm2,其他参数相同,ESD器件的布局顶视图如图 2a所示。第二组中3个器件D2长度分别为0、2、4 mm,面积为:1 177、1 251、1 357 mm2,其他参数不变,布局顶视图如图 2b所示。
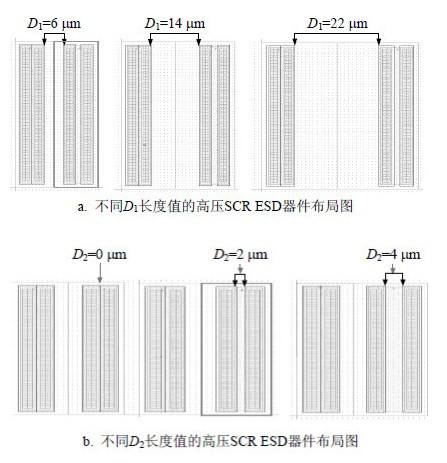 |
| 图2 长度值的高压SCR ESD器件布局图 |
TLP测试的I-V曲线和漏电流如图 3a所示。当D1长度从6、14 mm增加到22 mm,ESD器件的维持电压从2.29、5.92 V升高到9.64 V,如图 3b所示,维持电压近似线性的增长,求得斜率约为0.465 V/mm。采用失效电流除以器件面积求得单位面积的失效电流,经计算,单位面积的硬失效电流值Ihard分别为:3.92、3.28、2.53 mA/mm2,单位面积的软失效电流值Isoft为3.92、3.16、2.47 mA/mm2。单位面积的软失效电流曲线与硬失效电流曲线基本重合,随D1增长近似线性的递减,斜率测算约为-0.09 mA/mm2∙mm。
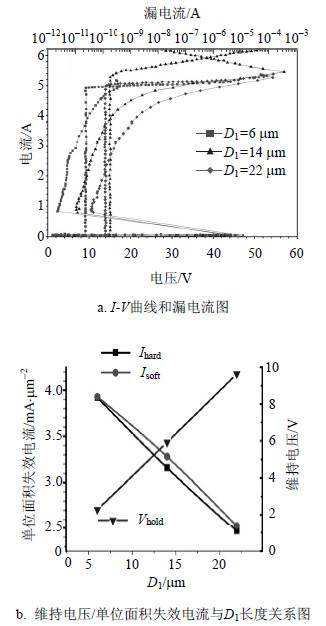 |
| 图3 不同D1长度器件的TLP测试图 |
如图 4所示,维持电压Vhold由载流子从发射区注入寄生BJT管的程度决定[10],因此,降低了寄生的BJT管发射效率可以增加维持电压。发射效率为:
| $\gamma = 1 - \frac{{{D_E}{W_B}{N_B}}}{{{D_B}{W_E}{N_E}}}$ | (1) |
式中,NB、NE是基区和发射区的载流子浓度;DB、DE是基区和发射区的少数载流子扩散系数;WB、WE是基区和发射区的宽度。如图 1、图 2a所示,随着D1增加,寄生NPN BJT和寄生PNP BJT基区宽度线性增大,由式(1)可知,两个寄生晶体管的发射效率线性降低,表明发射区载流子注入程度线性降低[11],维持电压随D1长度线性增长。Vhold增大加强了ESD器件的稳定性,器件的鲁棒性增强。
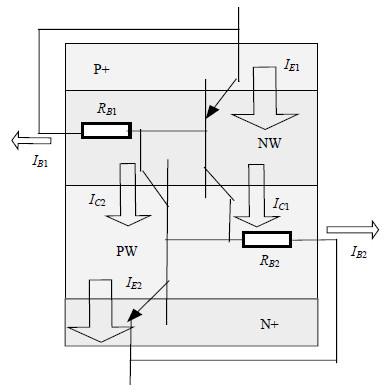 |
| 图4 器件的工作原理示意图 |
器件失效电流与D1长度关系可以从器件结构及热学原理方面分析。高压SCR ESD器件工作原理如图 4所示,P阱、N阱之间的PN结是两个寄生BJT管的集电结,SCR ESD器件放电产生的能量主要耗散在集电结上。设Pcm(Ta)是环境温度Ta时器件集电结的最大耗散功率,最高结温为Tjm,当环境温度为T时,集电结最大耗散功率为:
| ${P_{cm}} = \frac{{{T_{jm}} - T}}{{{T_{jm}} - {T_a}}}{P_{cm}}({T_a})$ | (2) |
由式(2)可知,集电结最大耗散功率Pcm与环境温度是负线性关系。
另一方面,集电结位于阱区内部,它的环境温度就是阱区(N阱与P阱的统称)温度T,由于ESD放电时间很短,可设器件为绝热体,同时采用单位面积失效电流值为评估值,可以不考虑器件体积变化导致的热容变化。如图 4所示,ESD放电时,阱区有大电流流过,阱区电阻RB1和电阻RB2上消耗的能量转化为焦耳热,引起阱区温度(T)升高,当器件为绝热体并且不考虑热容变化时,温度值随焦耳热增加线性增长。进一步分析可知,D1长度就是阱区宽度,D1长度增长,阱区电阻RB1、RB2正比增大, 器件工作时电流产生的焦耳热也正比增大(W=I2R),引起阱区温度(T)线性升高。因此阱区温度与D1长度也是正线性关系。
当器件为绝热体并且不考虑热容时,可以认为器件的失效电流值随Pcm值增大而线性增长,根据Pcm与T、T与D1长度关系,可知Pcm与D1长度是负线性关系。因此,器件的失效电流值与D1长度是负线性关系,随D1长度增大而线性减小。
2.3 应用与仿真分析为了验证上述结论的普遍性,根据文献[12]的研究成果,采取拟合和仿真的方式,本文对实验结果进行了验证和深入研究。
由于硬失效电流曲线与软失效电流曲线基本重合,采取软失效电流值为器件的二次击穿电流测量值,根据维持电压和单位面积的失效电流随D1长度线性变化的规律,拟合得到如下等式可得:
| ${V_{{\rm{hold}}}} = 0.465 \times ({L_{D1}} - 6) + 2.29$ | (3) |
| ${I_{t2}} = - 0.09 \times ({L_{D1}} - 6) + 3.92$ | (4) |
式中,It2是单位面积的二次击穿电流值,单位为mA/mm2。为了研究式(3)、式(4)的普遍性和适用范围,本文通过silvaco TCAD和spice仿真,得到3个器件工作时I-V曲线,如图 5所示。
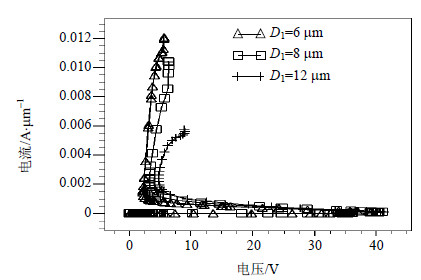 |
| 图5 不同D1长度器件的ESD放电I-V曲线仿真图 |
如图 5所示,维持电压是器件第一次回扫路径的最小值,器件的二次击穿发生在曲线的顶点位置,电流值分别为:12.5、10.5和7mA/mm,除以电极宽度(3 mm)得到单位面积失效电流值,维持电压和失效电流如表 1所示。
| 表1 D1长度变化时的维持电压和失效电流值 |
如表 1所示,维持电压的仿真结果和式3的计算结果基本吻合,可以在实际设计中通过改变此间距得到预计的维持电压,从而调控高压ESD保护器件的健壮性。失效电流仿真值与计算值相比较,在D1长度较小时误差小,但在D1长度较大时误差较大,原因如图 2a所示,D1大,器件体积大,器件的热容增大,热传递效应不能忽略,因此式4适用于D1长度较小范围。
3 D2长度对器件性能的的影响TLP测试结果如图 6a所示。随着D2长度增加,器件维持电压Vhold分别是2.4、2.29、3.689 V,单位面积的软失效电流Isoft为3.81、3.92、2.70 mA/mm2,单位硬失效电流Ihard为3.81、3.92、2.84 mA/mm2,由图 6b可知,单位面积的失效电流与维持电压与D2长度无线性关系,两者随D2长度变化正好相反,因此D2长度变化对器件的ESD鲁棒性和泄放性能的影响是相反的。但触发电压Vn从44.48、44.02 V减小到41.65 V,随D2增加单调降低。原因如图 4所示,D2长度的变化将导致NPN寄生管基区电阻RB2的变化,RB2阻值随D2长度增长而增加,小的雪崩电流就可以使NPN管的基-射极电压达到导通值($V = {I_{{R_{B2}}}}{R_{B2}} \approx $ 0.6 V),因此需要的雪崩击穿电压变小,导致器件进入放电保护工作状态的启动触发电压减小。
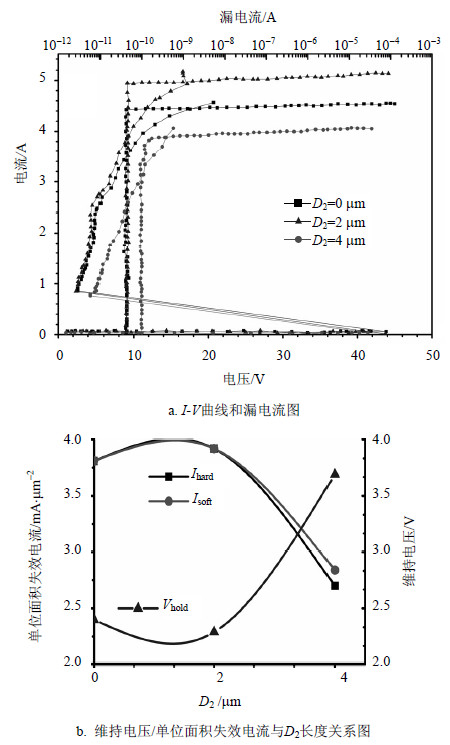 |
| 图6 不同D2长度器件的TLP测试图 |
根据实验结果和理论分析,高压SCR ESD器件的重要性能参数与结构尺寸密切相关,随着N阱内P+区和P阱内N+区间距增大,ESD器件的维持电压线性增大,而单位面积的失效电流线性减小,表明此间距变化对器件鲁棒性和泄放能力的作用相反。拟合得到维持电压和单位面积失效电流的线性公式,并软件仿真验证公式的准确性,结果表明,维持电压的计算值与仿真值误差很小,但失效电流计算值在间距较大时与仿真值偏差较大。另一方面,P阱内N+区和P+区间距增大,器件的触发电压单调下降,可用于高压SCR ESD器件的低电压触发设计。
| [1] | BART K, MERGENS M P J, TRINH C S, et al. ESD protection solutions for high voltage technologies[J]. Microelectronics Reliability, 2006, 46: 677-688 |
| [2] | TAZZOLI A, MARINO F A, CORDONI M, et al. Holding voltage investigation of advanced SCR-based protection structures for CMOS technology[J]. Microelectronics Reliability, 2007, 47: 1444-1449 |
| [3] | YANG Liu, WANG Yang, ZHOU Acheng, et al. Design, fabrication and test of novel LDMOS-SCR for improving holding voltage[J]. Solid-State Electronics, 2015, 103: 122- 126 |
| [4] | PAN Hong-wei, LIU Si-yang, SUN Wei-feng. A novel latch-up free SCR-LDMOS with high holding voltage for a power-rail ESD clamp[J]. Journal of Semiconductors, 2013, 34(1): 53-57 |
| [5] | LIN Li-juan, JIANG Ling-li, FAN Hang, et al. Impact of parasitic resistance on the ESD robustness of high-voltage devices[J]. Journal of Semiconductors, 2012, 33(1): 59-63. |
| [6] | SALCEDO A, LIOU J, LIU Zhi-wei, et al. Vinson TCAD methodology for design of SCR devices for electrostatic discharge (ESD) applications[J]. IEEE Transactions on Electron Devices, 2007, 54(4): 822-832 |
| [7] | GUIDO N, FRED K, JAN M L. Using an SCR as ESD protection without latch-up danger[J]. Microelectronics Reliability, 1997, 37(10/11): 1457-1460. |
| [8] | JIANG Ling-li, ZHANG Bo, FAN Hang, et al. ESD robustness studies on the double snapback characteristics of an LDMOS with an embedded SCR[J]. Journal of Semiconductors, 2011, 32(9): 34-37. |
| [9] | CHANG W J, KER M D. The impact of drift implant and layout parameters on ESD robustness for on-chip ESD protection devices in 40-V CMOS technology[J]. IEEE Trans Device Mater Reliability, 2007, 7(2): 324-332. |
| [10] | VASHCHENKO V A, CONCANNON A, TER BEEK, et al. High holding voltage cascaded LVTSCR structures for 5.5 V tolerant ESD protection clamps[J]. IEEE Trans Device Mater Reliab, 2004, 4(2): 273-280. |
| [11] | MENEGHESSO G, TAZZOLI A, MARINO F A, et al. Development of a new high holding voltage SCR-based ESD protection structure[C]//IEEE International Reliability Physics Symposium. Phoenix, AZ, USA: IEEE, 2008. |
| [12] | LI Wang, RUI Ma, CHEN Zhang, et al. Scalable behavior modeling for SCR based ESD protection structures for circuit simulation[C]//IEEE International Symposium on Circuits and Systems (ISCAS). Melbourne, Australia: IEEE, 2014. |
 2015, Vol. 44
2015, Vol. 44
